中科院微电子所突破Chiplet热仿真技术
2025年02月26日 09:55 发布者:eechina
据中国科学院微电子研究所官微消息,针对当前芯片高密度集成所带来的功耗显著增加与散热困难等技术挑战,微电子所EDA中心多物理场仿真课题组经过不懈努力,成功构建了芯粒集成三维网格型瞬态热流仿真模型。这一重要技术成果,不仅实现了对Chiplet集成芯片瞬态热流的高效精确仿真,还为芯粒异构集成的温度热点检测和温感布局优化奠定了坚实的技术基础。近年来,随着芯片集成化程度的不断提高,功耗与散热问题愈发凸显。传统的散热设计已难以满足高性能芯片的需求,特别是在Chiplet(芯粒)异构集成技术快速发展的背景下,温度控制成为了制约芯片性能提升的关键因素之一。为了攻克这一难题,中科院微电子所EDA中心多物理场仿真课题组深入开展了相关研究。
此次构建的芯粒集成三维网格型瞬态热流仿真模型,采用了先进的计算方法,能够准确模拟Chiplet集成芯片在复杂工况下的热流分布。该模型不仅具备高精度,还能够高效地处理大规模数据,为科研人员提供了强有力的仿真工具。通过该模型,科研人员可以更加直观地了解芯片内部的温度分布情况,及时发现潜在的温度热点,并采取相应的散热措施,确保芯片的稳定运行。

图1 各向异性热仿真
此外,该模型还为温感布局优化提供了重要支持。科研人员可以根据仿真结果,合理布置温度传感器,实现对芯片温度的实时监测与精确控制。这不仅有助于提高芯片的散热效率,还能够延长芯片的使用寿命,降低因温度过高而导致的故障率。
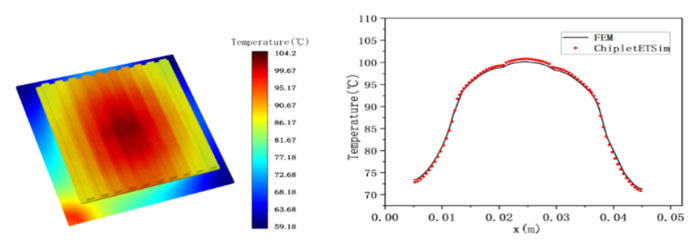
图2 电热耦合仿真

图3 热仿真模拟器
值得一提的是,中科院微电子所EDA中心多物理场仿真课题组在集成芯片电热力多物理场仿真方面也取得了显著进展。他们开展了直流压降、热应力和晶圆翘曲等多方面的研究工作,为全面解决芯片散热问题提供了更加全面的技术支撑。
