英特尔:浸入式光刻能延伸到11纳米
2010年02月26日 10:09 发布者:嵌入式公社
英特尔的先进光刻和制造部的Yan Borodovsky表明,英特尔希望EUV或者无掩模电子束光刻能作为193纳米浸入式光刻在11 纳米的后补者,并声称11 纳米可能发生在2015年。Borodovsky表示193nm浸入式光刻技术可能延伸到分别在2011和2013年的22nm及16nm 中。
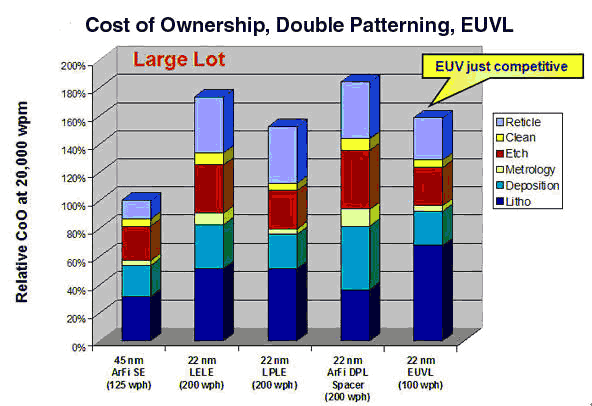
在Nikon的年会上许多其它的专家似乎对于EUV光刻也有相似的看法。如Nikon的光刻机设计部总经理Masato Hamatani认为,当EUV达到所有的预定目标时,进入量产可能要到2019年,即16nm以下水平。因此EUV对于22nm半间距己经太迟了,所以只能让16nm及以下的客户使用。从两次曝光和EUV光刻的成本看到EUV与其它技术相比缺乏竞争性。
Hamatani谈到对于EUV技术存在不少其它的替代方法,如通过掩模源程序的最佳化和定制照明来延伸单个图形技术。Hamatani说在可供选择之中有可供32nm半间距及以下的所谓间距两次曝光,pitch splitting两次曝光,如称之为LELE,LFLE及line cutting 光刻技术。能够精确和稳定的图形测量是关键,包括使用为了减少误差的带干涉仪的编码系统,和EUV相比较两次图形曝光比较省钱。
三星电子的首席技术官Jeong Ho Yeo表示希望采用两次图形曝光和EUV能继续的把存储器的尺寸缩小。Yeo又说它的观点是由于成本及图形的复杂性,采用多束形成图形作为一种解决方案可能不现实。为了降低存储器生产中的成本,低成本的两次图形曝光技术是有前途的。
在两次图形曝光技术中CD控制是个挑战,需要从技术上去突破。通过平台功能或者某些自对准方法可以达到所需的套准精度。
Yeo认为EUV光刻被证明可达到小於20nm的分辨率,包括4XDRAM的接触层。虽然如此,Yeo说对于EUV技术尚还有三个挑战。即无缺陷的EUV掩模;高功率EUV光源及相应的光刻胶。在大量制造时空白掩模的缺陷密度在25nm時要求<0,003/cm2。而目前状态仍有比较大的差距,在18nm时为1/cm2水平。关于光刻胶方面,在形成22m半间距 pitch 图形時尚存在差距,如胶的倒塌,分辨率,LWR,放气和灵敏度。
Nikon的总经理 Takaharu Miura认为EUV作为未来的光刻技术尚未就绪,表示目前非常可能是采用延伸ArFi 193nm的两次图形曝光技术。他认为作为一项大生产要求的设备必须要能够具备多代使用的技术能力。在22nm及16nm半间距时,镜头的NA 要>0,3,而在16nm及11nm半间距时NA要>0,4。关于EUV的光源问题,Miura指出系统必须能提供长时间运行的考验。在掩模方面尚有大量问题需要解决,需要提供光化学的检验与验证设备。
Nikon的院士Soichi Owa,它希望浸入式光刻技术,再加上四倍间距和line cutting光刻能延伸到SRAM的10nm半间距能力。目前的挑战是适合于EUV的光刻胶和因为需要多次曝光,所以必须减少掩模成本。同時在工艺过程中的检测十分关键。
Synopsys公司光刻部经理Kevin Lucas认为目前的工艺和设备己经为间距分离的两次图形曝光技术作好了准备,无论逻辑或者存储器产品,尤其是接触及互连层中使用。然而,为了取得成功需要增加设计与掩模制造的综合。它认为从设计规则对于逻辑和存储器采用两次图形曝光都是可能的。当把整个芯片进行复杂度和尺寸分解处理之后,Lucas认为接着OPC和验证对于两次图形曝光的成品率十分重要。采用适当的设计限制多次曝光图形能进一步缩小尺寸。

来源:Semiconductor International
