将超越三星!台积电宣布450mm晶圆项目
2011年02月22日 00:07 发布者:1770309616
来自台北的消息,台积电近日宣布开始计划投资共100亿美元左右的资金,来开发450mm晶圆工厂项目,预计该项目将在2013年正式投产,2015年将会在其基础上进行20nm制程产品的研发,并实现真正量产。 通过之前的信息可以知道,台积电第二家宣布投资450mm晶圆计划的芯片厂(第一家为Intel)。若此项目能按时完成,那么台积电的芯片制作工艺将大幅超越三星和GlobalFoundires,并接近Intel的水平。在德国芯片技术论坛中,台积电首席技术总监曾提到建造450mm的晶圆厂,对于降低成本具有重大意义。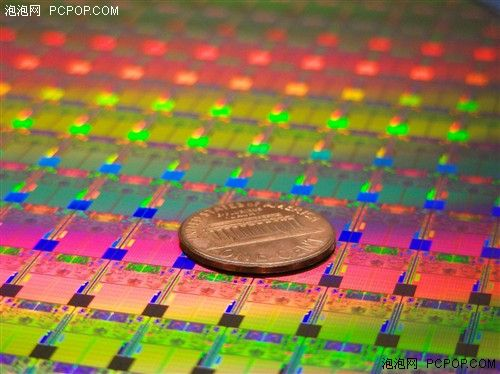

据知情人士透露,台积电将逐步在Fab12工厂的第四期厂房中安装450mm晶圆试产生产线,该地点选在台湾新竹科技园区内。而最终的量产生产线,将逐步在Fab15厂的第5期厂房中安装。
附一:
提速20倍!美光宣布混合存储立方体技术
美光公司在一场投资者会议上宣布了自己在内存技术领域的新突破。这项创新技术名为“混合存储立方体”(Hybrid Memory Cube,HMC),号称单颗HMC芯片的性能是DDR3内存条的20倍。美光DRAM内存业务副总裁Brian M.Shirley表示,内存带宽问题如今往往会成为计算机系统的瓶颈。而其症结往往在于总线,即从DRAM内存芯片读写的数据无法马上达到处理器。他举 例称,DDR2到DDR3的升级被屡屡推迟就是如此,因为人们无法从升级DDR3看到内存性能的提升。
为解决这一问题,HMC采用了堆叠封装技术,将多层DRAM和一个逻辑电路层封装在一起,并通过TSV硅穿孔技术进行互联。这种立体的结构因此才被称为“立方体”。

美光表示,HMC技术的关键就在于底层的这一层逻辑层,它实际上扮演了内存控制器的角色,可以使用超高带宽总线和CPU连接,消除内存与CPU之间的带宽/性能瓶颈。
据称,单颗HMC芯片的性能超过DDR3内存条20倍以上,同时单位bit存储空间的功耗仅仅是现有内存技术的十分之一,同等容量HMC的体积也仅仅是目前使用RDIMM内存条的十分之一。
HMC技术将首先应用于高性能领域,比如100Gbps高速网络设备或超级计算机等。预计首批HMC企业级产品将在2012年亮相,2013年大批量推出,2015、2016年左右进入消费领域。
