台积电北美副总裁谈台积电Gate-last HKMG技术及后续发展
2010年11月29日 10:08 发布者:李宽
台积电北美公司副总裁马玓日前在IEE纳米技术委员会举办的一次会议上展示了台积电28nm及更高级别制程方面的发展方向和主要技术难点。会上他在接受electroiq网站的高级技术编辑Debra Vogler访谈的过程中,总结了台积电在HKMG架构之后的晶体管制作技术的主要发展方向,他并表示台积电正在尝试用不同的物质层淀积次序来增强HKMG栅极结构,以增强HKMG产品的稳定性。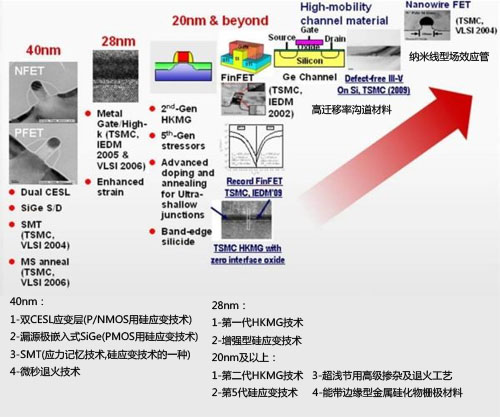
他表示,促使台积电选择Gate-last工艺制作HKMG的因素主要有五个:速度,功耗,可靠性,可制造性以及可伸缩性。他表示为了兼顾这五个因素,必须采用优化的解决方案,台积电给出的数据显示gate-last工艺可以将器件的功耗保持在较低的水平。
从制造性方面看,使用Gate-last工艺后,所有高温制程均可以放在HK+MG材料淀积之前制作完成,这样便可以保证管子的门限电压参数的稳定性。
另外,马玓还在访谈过程中提及了台积电在Finfet(垂直型晶体管),高迁移率沟道材料技术(III-V族技术)以及3D芯片互联技术等HKMG之后未来的晶体管技术发展方向。有关的访谈录音可点击这个链接收听.
